
The All-Round Solution
ホットエアー SMDリワークステーション
FINEPLACER® core plus は、電子部品およびアセンブリ用の汎用のホットエアー リワークステーションです。
コンポーネントのはんだ除去およびはんだ付け、そして残留はんだ除去とリボールも含む完全なリワークサイクルは、一つのコンパクトなリワークシステム上で実行されます。 対応可能な表面実装デバイスの範囲は、非常に小さい01005から大きなコンポーネント(BGA)まで対応することが可能です。
対象基板の全領域をカバーするボトムヒーティングモジュールは、民生用電子機器(タブレット、ラップトップ、ゲームコンソール)または医療製品(MRTデバイスなど)の中型PCBの再加工に最適です。
あらかじめインストールされたプロファイルライブラリと直感的かつ視覚的なユーザーインターフェースにより、オペレーターはもすぐに作業を開始することができます。 デジタルトップヒーターキャリブレーション、精密タッチダウンフォース制御、ライブプロセス観察などの数多くの専門的な機能により、FINEPLACER® core plus は、要求が厳しくなるであろう将来を見据えた投資となりえます。


Contact Us
アプリケーションとテクノロジー
小型の008004コンポーネントから大規模なBGAまで、当社のプロフェッショナルなSMDリワークシステムは、幅広いアプリケーションとプロセスに対応し、あらゆるSMDリワークの課題に取り組む準備ができています。業界をリードする温度プロファイル管理機能を持ち、かつモジュール方式のハードウェアとソフトウェアのアーキテクチャを採用しています。このSMDリワークシステムは、SMDリワークサイクルにおけるすべての工程で再現性のあるプロセス結果をもたらすように設計されています。
- BGA, CSP, QFN, DFN, QFP, PGA, SOT etc.
- Package on Package (PoP)
- Underfilled and coated components
- RF shields & RF frames
- Mini BGA and other miniaturized components
- Connectors & Sockets
- Small passives down to 008004
- Rework on FR4, flex, glass, ceramic or aluminium carrier
- LED and Mini LED arrays
- Daughter boards & Sub assemblies
機能 - モジュール - 拡張機能
当社のSMDリワークソリューションは、お客様の要件に応じて、幅広い構成オプションを提供します。 標準機能としてのシステムの基本機能に加えて、各システムで多数のプロセスモジュールを使用できるため、アプリケーションの範囲が広がります。 これらモジュールは、いつでも後付けが可能で、直接またはモジュールパッケージの一部として別のSMDリワークプロセスを追加する事を可能にします。 機能強化とアクセサリーシステムを選択することにより、SMDリワークシステムでの日常の作業が容易になり、特定のプロセスシーケンスをさらに効率化することができます。
- Hot Beam 04
Infrared underheater: 500 W heating power for the efficient and precise heating of PCBs. Unique features include a very compact design, fast response and targeted heating.
今すぐダウンロード (PDF, 0.6 MB) - Hot Beam 05
Infrared underheater: 2,000 W heating power to heat heavy PCBs. Unique features include a very compact design, large power density and a fast response heating source.
今すぐダウンロード (PDF, 0.7 MB) - Hot Plate
HOT PLATE 04 is a powerful 700 W conductive underheater that allows efficient work on heavy electrical systems with a flat bottom surface and LED PCBs.
今すぐダウンロード (PDF, 0.4 MB) - MiniOven 05
The MINIOVEN 05 is a robust, compact table-top system designed for easy re-balling of BGA components and pre-bumping of QFN components.
今すぐダウンロード (PDF, 1 MB) - RGW-Illumination
Description coming soon
- Smart Desolder 01
Non-contact extraction of residual solder using a manual hot-gas source with a vacuum pen. Remove components without re-applying heat and pressure to PCB.
今すぐダウンロード (PDF, 0.5 MB) - コンポーネント供給
GelPak®、VRトレイ、またはワッフルパックからのコンポーネントの安全な取り出しを確実なものにします。
今すぐダウンロード (PDF, 0.3 MB) - ズーム光学系
アライメントシステムの視野を調整して、コンポーネントと基板の最適化された視覚的情報を得る事が出来ます。
- タッチスクリーン(スマートコントロール)
確立されたマルチタッチ機能とナビゲーションを備えたソフトウェアが直感的な操作を可能にします。
今すぐダウンロード (PDF, 0.2 MB) - ターゲットファインダー
レーザースポットの小さな赤い点の補助により、ツールとテーブルの粗動アライメント操作がより容易になります。
今すぐダウンロード (PDF, 0.3 MB) - ダイレクトコンポーネントプリントモジュール
コンポーネントに直接印刷することにより、はんだペーストを簡単に塗布することができます。QFN、SON、およびMLFコンポーネントのリワークのための「オールインワン」ソリューションです
今すぐダウンロード (PDF, 0.3 MB) - ディスペンサーモジュール
接着剤、フラックス、はんだペースト、またはその他のペースト状材料を塗布するための総合的ディスペンシングシステムです。 時間-圧力、塗布量、ジェットディスペンサーなど様々な&
今すぐダウンロード (PDF, 0.3 MB) - デッピィング/スタンピングモジュール
接着剤またはフラックスを供給するための手動または電動のスキージユニットで、さまざまなサイズのダイに対応します。層厚に適応可能な回転式および直動式のバージョンがありま
- トレーサビリティモジュール
すべてのプロセス関連パラメーター(温度、力など)と、関連するコンポーネントの詳細(シリアル番号など)の自動追跡と記録。
- ハンダ除去モジュール
不活性雰囲気での正確な残留はんだ除去を可能にします。 パッドやソルダーレジストを乱すことなく、強力な真空で溶融はんだを基板から簡単に一度に除去できます。
今すぐダウンロード (PDF, 0.3 MB) - バーコードリーダー(SmartIdent)
オペレーティングソフトウェアの機能強化により、安全かつ高速に、全ての基板に固有のバーコードラベルの特定が可能です。
今すぐダウンロード (PDF, 0.3 MB) - プロセスガス切替モジュール
高温ガスとして用いる窒素を有効使用し、資源、エネルギー、およびコストを節約します。
今すぐダウンロード (PDF, 0.2 MB) - プロセススタートセンサー
再現性が重要であり、 再現可能なプロセス条件の為に、ボード表面の特定ポイントの温度を測定します。
今すぐダウンロード (PDF, 0.2 MB) - プロセスビデオモジュール
ボンディングプロセス中に作業領域のリアルタイム観察を可能にします。
今すぐダウンロード (PDF, 0.3 MB) - ホットガス ボトムヒーティングモジュール
局所的もしくは全エリアに対してボトムヒーティングを行うのかは、効率的問題があります。我々のアプローチでは熱は必要な箇所にだけ供給されるため、消費電力をセーブし、基板および
今すぐダウンロード (PDF, 0.4 MB) - リボールモジュール
残留はんだを除去した後、要求仕様のBGAまたはCSPコンポーネントではんだボールアレイを復元することで、時間とコストを節約しながらBGAとCSPを再利用出来ます。
今すぐダウンロード (PDF, 1.5 MB) - 上側加熱モジュール(加熱ガス)
高温ガスと各チップ専用のツール設計で上部からの熱伝達が可能になり、チップ側から温度を加えることが可能です。
今すぐダウンロード (PDF, 0.3 MB) - 分割視野光学系
大きなコンポーネントの対角2箇所と、対する基板のパッド領域を、高倍率で確認することができ、大きなコンポーネントを高精度に実装します。
- 固定式ビームスプリッターによるオーバーレイ・ビジョンアライメントシステム(VAS)
チップと基板の高精度ビジュアルアライメント
今すぐダウンロード (PDF, 0.7 MB) - 基板サポート
様々な基板を固定するための、基板に応じた固定法(真空など)を備えた非加熱式のサポートプレート。
今すぐダウンロード (PDF, 0.5 MB) - 基板加熱モジュール
プロセス中の基板の下側を加熱する機構。様々な直接接触加熱オプションがあり、仕様に合わせた基板固定も可能です。オプションでプロセスガスと組み合わせ使用も可能です。(使用例 熱圧着、熱接着、または超音波熱圧着など)
ビデオ
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

BGAリワーク
薄型テレビPCB基板のはんだ付け、デソルダリング、残留はんだ除去
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

BGAリボール処理
この動画では、BGA部品をリワークするためのFINEPLACER®ホットガスリワークシステムでの安全で簡単なリボールプロセスをデモンストレーションしています。また、BGAからの残留はんだの非接触除去も含まれています。
By using this element, you agree that your data will be transmitted to external services (https://www.youtube-nocookie.com) and that you have read our privacy policy.

GPUのリワーク
TCPU/GPUリワークの典型的なプロセスステップです。 これには、事前検査、基板準備、部品のプロファイリング、デソルダリング、リボール、はんだペースト印刷やディスペンスなどの特殊工程、新規/リワークされた部品のはんだ付け、そして最後に光学的検査によるフォローアップが含まれています。
技術文章
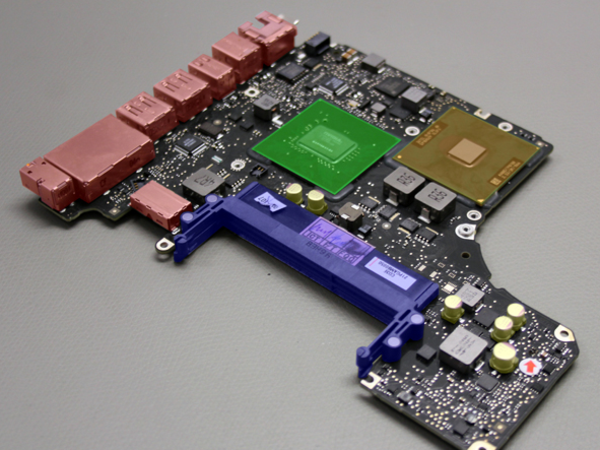
BGA/CSPとCPU/GPU SMDのリワーク

ミニLEDアレイのリワーク

技術文章ーの概要
Copyright © 2024 Finetech GmbH & Co. KG, All rights reserved.


